Harnessing Atomic Layer Deposition for Next‑Generation Micro‑LEDs and VCSELs
Abstract
Advances in nano‑fabrication have driven semiconductor devices to ever smaller dimensions, intensifying sidewall defects that undermine performance. Conventional plasma‑enhanced chemical vapor deposition (PECVD) struggles to deliver the conformality required at the nanometer scale. Atomic Layer Deposition (ALD) overcomes these challenges through self‑limiting surface reactions, delivering monolayer‑precision films with excellent step coverage. This review surveys recent progress in ALD‑based passivation of micro‑LEDs and vertical‑cavity surface‑emitting lasers (VCSELs), highlighting how tailored dielectric layers enhance light extraction, suppress leakage, and markedly improve reliability under harsh environmental conditions.
Introduction
Since the first patent filed by Dr. Tuomo Suntola in 1977, ALD has evolved from a niche research tool into a cornerstone of advanced semiconductor processing. By 2007, Intel demonstrated the first 45 nm HfO2 gate passivation on a metal‑oxide transistor, underscoring ALD’s precision and scalability. ALD relies on two temporally separated precursor pulses that react only at the surface, yielding self‑limiting monolayer growth. This mechanism ensures growth‑per‑cycle (GPC) values of 0.05–0.1 nm, allowing films to conform to high‑aspect‑ratio structures with nanometer‑scale uniformity. Unlike conventional CVD or PVD, ALD’s surface‑limited chemistry eliminates bulk reactions, yielding dense, pinhole‑free coatings essential for high‑reliability optoelectronic devices. The semiconductor community has embraced ALD for high‑k dielectrics, copper barriers, etch stops, and, crucially, for protective layers on LEDs and VCSELs. In OLED displays, for instance, water‑vapor transmission rates (WVTR) below 10−4 g m−2 day−1 are required, a benchmark routinely met by ALD films. For high‑power VCSELs, WVTR <10−3 g m−2 day−1 is essential to maintain performance in humid environments. This review focuses on ALD’s impact on micro‑LEDs and VCSELs, detailing passivation strategies, DBR enhancements, quantum‑well optimization, and transparent electrode deposition that collectively elevate device efficiency and longevity.
ALD Technologies for Micro‑LEDs
InGaN micro‑LEDs, the intrinsic piezoelectric fields give rise to the quantum‑confined Stark effect (QCSE), which shifts emission wavelength and degrades carrier recombination. Recent work has leveraged ring‑shaped nanostructures to relax strain and modulate the QCSE, but the benefits are curtailed by sidewall damage when device dimensions shrink below 20 µm.
While PECVD can deposit high‑k dielectrics rapidly, its loading effects and limited conformality make it suboptimal for sub‑10 µm devices. ALD, in contrast, delivers nanometer‑thick, dense films with superior step coverage and uniformity, even at low deposition temperatures (< 200 °C). Studies by Koehler et al. have shown that ALD‑grown Al2O3 and HfO2 layers reduce leakage currents by up to 80 % compared to PECVD, while simultaneously increasing external quantum efficiency (EQE) by 20–30 % for devices as small as 5 µm. Figures 3 and 4 illustrate the dramatic improvement in reverse‑bias leakage and integrated optical power when ALD is used for sidewall passivation.
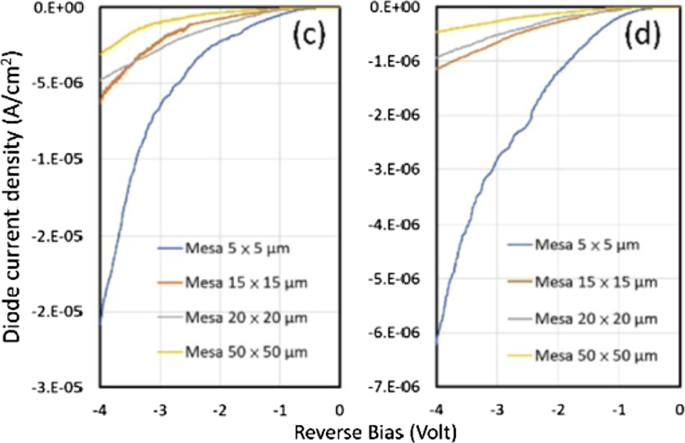
Reverse‑bias J‑V curves of micro‑LEDs with PECVD (a) and ALD (b) sidewall passivation [68]
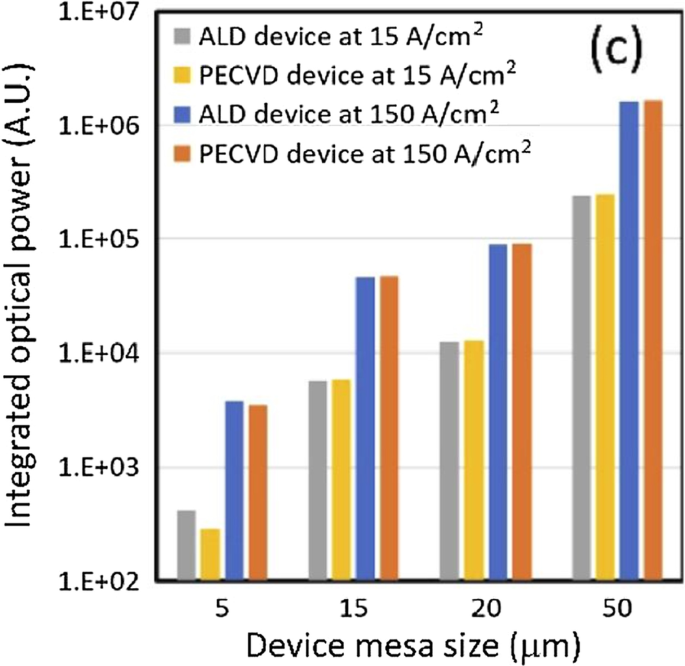
Integrated spectral intensity comparison between ALD and PECVD passivation across current densities [68]
EQE measurements further confirm ALD’s advantage: for 20 × 20 µm2 micro‑LEDs, ALD‑passivated devices reach 33 % EQE versus 24 % for PECVD, a 37 % relative improvement. In larger 100 × 100 µm2 devices, the sidewall ratio diminishes, and EQE converges across methods, underscoring ALD’s critical role at the microscale.
In summary, ALD‑based sidewall passivation mitigates defect‑induced leakage, preserves carrier recombination, and sustains high luminous efficacy as micro‑LEDs scale down—an essential capability for next‑generation display and lighting technologies.
ALD Technologies for VCSEL
Oxide‑confined VCSELs offer low jitter and high modal stability, but their high‑power operation makes them vulnerable to moisture ingress and thermal stress. The VCSEL architecture—p‑DBR, active cavity, n‑DBR—requires layers with reflectivity > 99 % and minimal interfacial roughness to maintain low threshold currents.
Passivation Layers
Traditional PECVD deposition demands thick Al2O3 layers to achieve sufficient barrier performance, which introduces stress and degrades reliability. ALD, by depositing 5–10 nm of Al2O3 with atomic precision, provides a dense, pinhole‑free barrier that encapsulates the mesa sidewalls without excess stress. In an 85 °C/85 % RH aging study, devices coated with ALD‑grown Al2O3 + PECVD SiNx survived 960 h, compared to 500 h for SiNx alone, demonstrating a 92 % improvement in wet high‑temperature operation life (WHTOL).
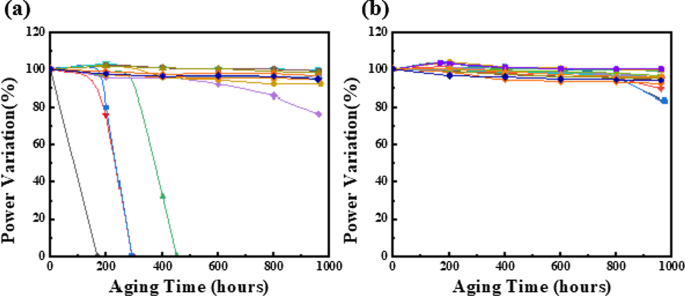
WHTOL (85 °C/85 % RH) of VCSELs: (a) SiNx only, (b) Al2O3 + SiNx passivation
DBR Enhancements
ALD enables precise control of the quarter‑wave thicknesses of high‑index/low‑index pairs such as HfO2/Al2O3. Transmission electron microscopy confirms sub‑nanometer interface roughness and sharp compositional boundaries (Fig. 12). Compared to MOCVD, ALD‑grown DBRs exhibit higher reflectivity and lower insertion loss, as shown by transfer‑matrix calculations (Fig. 13).
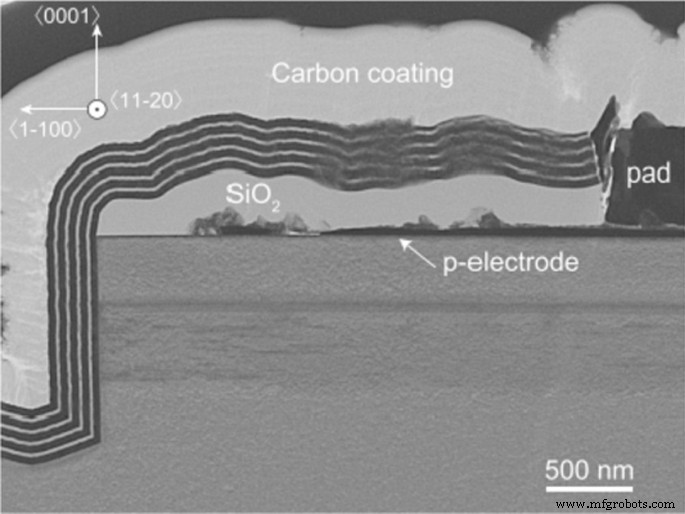
TEM image of ALD‑deposited HfO2/Al2O3 DBR [84]
Multiple Quantum Wells
For VCSELs operating in the 850‑nm band, ALD‑based anti‑reflection (AR) coatings and surface passivation of InGaAs/GaAs MQWs reduce non‑radiative recombination by > 15 %. Surface‑treated MQWs (e.g., HCl or NH4OH) followed by Al2O3 ALD preserve indium content while introducing a thin oxide that mitigates surface states (Fig. 15).
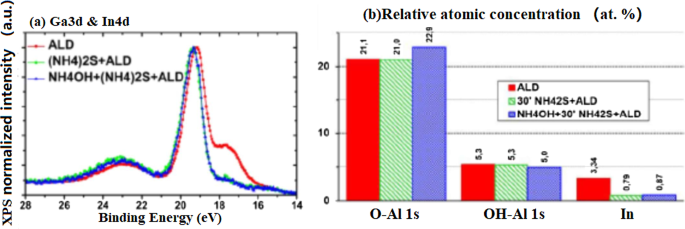
Effect of surface treatments on InGaN before Al2O3 ALD [86]
Transparent Electrodes
Conventional Ti/Au contacts absorb emitted photons and limit current spreading. ALD‑grown indium‑tin‑oxide (ITO) films provide > 96 % transmittance and excellent sheet resistance, yielding a 27 % boost in output power for 850‑nm VCSELs compared to metal contacts. Recent work demonstrates that ALD‑deposited ZnO and Al2O3 layers can further improve current uniformity and reduce optical loss.
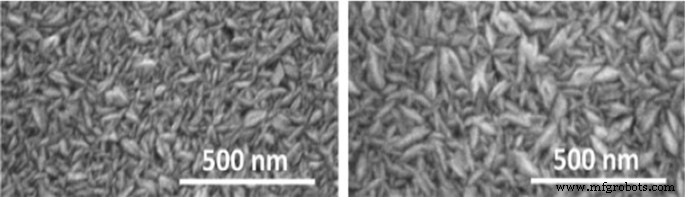
SEM images of ZnO films deposited by ALD and CVD for transparent electrodes
Conclusions
ALD has proven indispensable for the next wave of optoelectronic devices. Its monolayer‑level control enables sidewall passivation that suppresses leakage in micro‑LEDs and protects oxide‑confined VCSELs from moisture and thermal stress. Al2O3/SiNx stacked dielectrics, ALD‑grown DBRs with precise thickness, and high‑transparency TCO electrodes collectively raise device efficiency, reliability, and scalability. Continued integration of ALD in semiconductor fabs promises further gains in power handling, data‑rate capacity, and energy efficiency for future display, lighting, and communication systems.
Availability of data and materials
The data supporting this review are available from the corresponding authors upon reasonable request.
Abbreviations
- PECVD:
Plasma‑enhanced chemical vapor deposition
- ALD:
Atomic layer deposition
- LED:
Light‑emitting diode
- VCSEL:
Vertical cavity surface‑emitting laser
- CVD:
Chemical vapor deposition
- PVD:
Physical vapor deposition
- GPC:
Growth per cycle
- HKMG:
High‑K metal gate
- FinFET:
Fin field‑effect transistor
- WVTR:
Water vapor transmission rate
- OLED:
Organic light‑emitting diode
- MEMS:
Micro‑electro‑mechanical systems
- μLED:
Micro‑LED
- WHTOL:
Wet high‑temperature operation life
- OOK:
On–off keying
- PAM4:
Amplitude modulation 4‑level
Nanomaterials
- Optimized HfO2/TiO2/HfO2 Trilayer RRAM: Electrode-Dependent Bipolar Switching and Enhanced Uniformity via Atomic Layer Deposition
- Optimizing HfO₂/Ge Gate Dielectrics: In Situ SiO₂ Interlayers via PEALD Enhance Interface, Electrical, and Band Alignment
- Hierarchical ZnO/Polyamide‑6 Nanofibers with Enhanced Antibacterial Activity Fabricated by Atomic Layer Deposition and Hydrothermal Growth
- Plasma‑Enhanced ALD of Co₃O₄ on TiO₂ Boosts UV Photocatalytic Degradation of Methylene Blue
- Ultra‑Thin TiO₂ Nanomembranes via Atomic Layer Deposition Deliver Record‑High Capacitance for Pseudocapacitor Electrodes
- Al₂O₃‑Coated Microchannel Plates via Atomic Layer Deposition Deliver Five‑Fold Gain and Extended Lifetime
- Optimizing Buffer Layers via Atomic Layer Deposition for High‑Performance Vertically Aligned Carbon Nanotube Arrays
- Co‑Sputtering and ALD Fabricated Ag Nanoparticle SERS Substrate: High Sensitivity and 30‑Day Stability for Glycerol Detection
- Optimizing ZnO Thin Film Growth by Co-Depositing Ozone and Deionized Water in Atomic Layer Deposition
- Advanced In‑Situ FT‑IR/QMS Monitoring of CpZr(NMe2)3 Decomposition for Reliable ALD Processes



