Eliminating Bimodal Size in InAs/GaAs Quantum Dots for 1.3‑µm Quantum Dot Lasers
Abstract
Recent advances in active‑layer engineering have significantly boosted the performance of semiconductor quantum‑dot (QD) lasers. Self‑assembled InAs QDs grown on GaAs substrates are a leading platform for 1.3‑µm lasers, yet the presence of a bimodal size distribution hampers uniformity and device yield. This study demonstrates that a single‑layer high‑temperature anneal at 680 °C effectively suppresses the bimodal size, yielding QDs with a narrow photoluminescence (PL) linewidth (< 26 meV) and a uniform density of 3.2 × 1010 cm−2. The resulting Fabry–Perot (F‑P) laser achieves a low threshold current density of 110 A cm−2 at 1.3 µm in continuous‑wave operation.
Introduction
While the first 1.3‑µm QD laser appeared a decade ago, substantial progress in growth technology has only recently unlocked its full potential. A high density of well‑controlled QDs is essential for low‑power, high‑temperature, and high‑speed operation, making the InAs/GaAs system a prime candidate for next‑generation optical interconnects. However, the large lattice mismatch (~ 7 %) between InAs and GaAs often produces a bimodal size distribution, which broadens the emission spectrum and degrades laser performance. Eliminating this size bimodality is therefore critical for achieving high‑quality, low‑threshold devices.
Growth of InAs on GaAs(001) via molecular beam epitaxy (MBE) follows the Stranski–Krastanov (SK) mechanism, forming three‑dimensional islands that can be tuned by deposition rate and growth temperature. Conventional strategies—high InAs flux and low substrate temperature—boost dot density but introduce lattice defects, reducing PL intensity. In contrast, a post‑growth, single‑layer anneal can heal defects, homogenize dot size, and enhance the crystalline quality of the cap layer, as demonstrated in this work.
Material Optimization
All samples were grown on GaAs(001) (N+) substrates in a Veeco Gen 930 MBE system. Four test wafers (N170813, N170824A–C) were annealed at 630, 680, 730, and 780 °C, respectively, with identical growth parameters (Table 1).
Photoluminescence measurements revealed the strongest PL intensity at 680 °C (Fig. 1). The increase in annealing temperature promotes desorption of excess As and Ga, reducing surface defects while preserving QD lattice integrity.
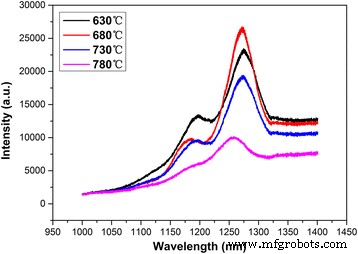
Comparison of photoluminescence spectra under different annealing temperatures.
Key growth parameters were optimized: arsenic pressure was set to 4 × 10−7 Torr, and the InAs deposition rate to 0.025 ML s−1. A 2.5 ML InAs layer was grown at 520 °C, capped by 5 nm In0.15Ga0.85As, followed by 15 nm GaAs at 520 °C and a final 20 nm GaAs layer at 630 °C (Fig. 2a).
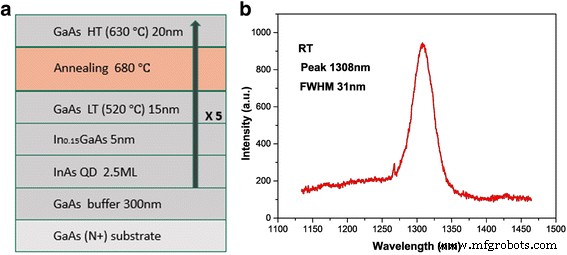
The active‑region structure and its room‑temperature PL spectrum: peak at 1305 nm with a 31 nm FWHM.
AFM imaging of the annealed sample (Fig. 3a) shows a uniform QD density of 3.2 × 1010 cm−2 and an average height of 8 nm. In contrast, the non‑annealed sample (Fig. 3b) exhibits a bimodal distribution (5–7 nm) and a lower density of 2.9 × 1010 cm−2.
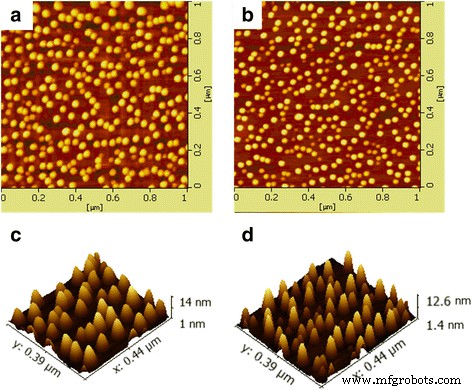
AFM images: (a) annealed, (b) non‑annealed, (c) size distribution with annealing, (d) size distribution without annealing.
The anneal not only homogenizes dot size but also repairs the GaAs cap layer, reducing dislocations that would otherwise propagate into the QD layer. The resulting 1.3‑µm emission spectrum is narrowed, with a PL peak at 1308 nm and a 31 nm FWHM.
Device Design and Preparation
The laser stack consists of five InAs QD layers sandwiched between 1.8 µm Al0.45Ga0.55As waveguide layers (n‑type Si: 2 × 1018 cm−3, p‑type Be: 4 × 1018 cm−3). A 200‑nm p+ GaAs (Be: 3 × 1019 cm−3) layer provides a low‑resistance contact (Fig. 4a).
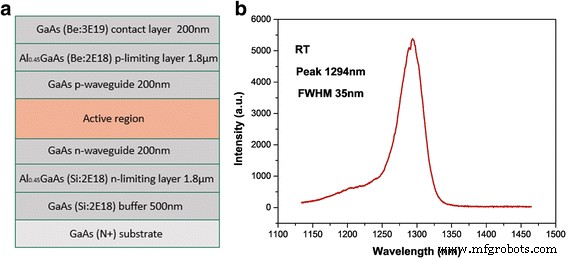
Device structure: (a) epitaxial layers; (b) room‑temperature PL with a 1294 nm peak.
After epitaxy, the upper cladding was chemically thinned (H3PO4–H2O2–H2O 1:1:4). This step shifts the PL peak to 1294 nm due to a higher growth temperature (650 °C) and indium drift in the In0.15Ga0.85As cap.
Photolithography defined a 100 µm ridge, etched to 2 µm via ICP, and insulated with 260 nm SiO2 (PECVD). Contact windows (90 µm) were opened for current injection, and Ti/Pt/Au (51/94.7/1122 nm) electrodes were sputtered on the front side. The wafer was thinned to 120 µm; a 50 nm AuGeNi (80:10:10 wt%) alloy followed by 300 nm Au was evaporated on the back for the n‑type electrode. A 460 °C, 10 s anneal formed ohmic contacts.
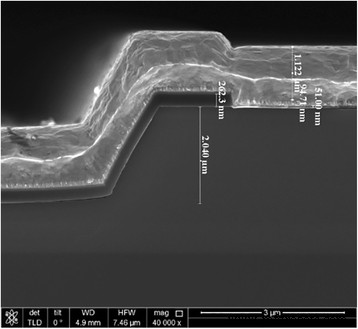
SEM cross‑section: 2 µm GaAs/AlGaAs etch depth, 260 nm PECVD SiO2.
Electrical and optical performance were measured in CW at room temperature. The device exhibits a threshold current density of 110 A cm−2 and a lasing wavelength centered at 1.3 µm (Fig. 6). The red‑shift of the lasing peak relative to the PL is attributed to self‑heating during operation. No facet coating or active‑region doping was required, underscoring the high crystalline quality achieved through single‑layer annealing.
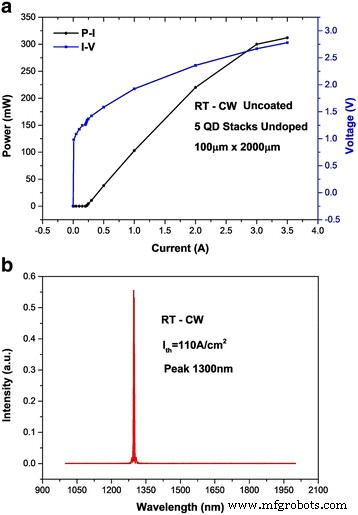
Device measurements: (a) P‑I‑V curves; (b) lasing spectrum at 1.3 µm.
Conclusions
By systematically optimizing growth and annealing conditions, we successfully eliminated the bimodal size distribution in InAs/GaAs QDs. The optimal single‑layer anneal at 680 °C, performed 20 nm above the QD layer, yields a uniform dot ensemble and a high‑density of 3.2 × 1010 cm−2. The resulting 1.3‑µm Fabry–Perot laser achieves a low threshold current density of 110 A cm−2 in continuous‑wave, room‑temperature operation, demonstrating the viability of this approach for high‑performance QD laser applications.
Abbreviations
- AFM:
Atomic Force Microscope
- Annealing T:
Annealing temperature
- CW:
Continuous wave
- F-P:
Fabry–Perot
- FWHM:
Full width at half maximum
- Growth T:
Growth temperature
- HT:
High temperature
- LT:
Low temperature
- MBE:
Molecular beam epitaxy
- PL:
Photoluminescence
- QD:
Quantum dot
- RT:
Room temperature
- SEM:
Scanning electron microscope
- WPE:
Wall plug efficiency
Nanomaterials
- S,N‑Co‑Doped Graphene Quantum Dot/TiO₂ Composites for High‑Efficiency Visible‑Light Photocatalytic Hydrogen Generation
- High-Performance 1.3 µm Single-Photon Source Using InAs Bilayer Quantum Dots in Micropillar Cavities
- Optimizing Photovoltage in Metamorphic InAs/InGaAs/GaAs Quantum Dot Heterostructures: Design Insights for Light‑Sensitive Devices
- Enhanced Telecom-Range Photoconductivity in Metamorphic InAs/InGaAs Quantum Dots (1.3–1.55 µm)
- Dual-Mode InAs/GaAs Quantum Dot DFB Laser for Broad Tuning CW Terahertz Applications
- High‑Quality In₂S₃ Quantum Dots Synthesized at Room Temperature for Ultra‑Sensitive UV Photodetectors
- Synthesis, Structure, and Superior Capacitance of Sulfur‑Nitrogen Co‑Doped Graphene Quantum Dots
- Eco‑Friendly One‑Pot Hydrothermal Synthesis of Water‑Soluble WS₂ Quantum Dots for Sensitive Luminescent Detection of Hydrogen Peroxide and Glucose
- Significant Enhancement of Single‑Photon Emission via Optimized Coupling of InAs/GaAs Quantum Dot to Micropillar Cavity
- CKAP4-Linked Silicon Quantum Dot Micelles: A Novel Targeted Imaging Agent for Lung Cancer



