Mapping Bismuth Distribution in GaAsBi/GaAs Heterostructures Using Aberration-Corrected HAADF‑STEM
Abstract
Using aberration‑corrected high‑angle annular dark‑field (HAADF) STEM, we examined the distribution of Bismuth (Bi) in molecular‑beam‑epitaxy (MBE)–grown GaAs/GaAs1-xBix/GaAs heterostructures fabricated at a substrate temperature near 340 °C. Low‑magnification HAADF images, corroborated by energy‑dispersive X‑ray (EDX) analysis, revealed defect‑free layers but a non‑uniform Bi concentration at the interfaces and within the GaAsBi layer. High‑magnification quantitative HAADF (qHAADF) analysis confirmed Bi segregation at low Bi flux and the appearance of distorted dumbbell structures where Bi content is elevated. When the Bi flux is increased, the Bi gathering grows into ≈ 10–12 nm equiaxial particles faceted along zinc‑blende {111} planes, uniformly dispersed in the matrix and at interfaces. Fast‑Fourier‑transform (FFT) analysis detected coexistence of rhombohedral Bi (rh‑Bi) embedded within the zinc‑blende GaAs1-xBix matrix. These clusters locally relax the lattice, in agreement with X‑ray diffraction (XRD) measurements.
Background
GaAsBi semiconductors have attracted attention for temperature‑stable, mid‑infrared devices [1]. Incorporating small amounts of Bi into the GaAs lattice reduces the bandgap dramatically, a key optoelectronic effect [2, 3]. However, the weak Ga–Bi bond, large miscibility gap, and lattice mismatch make Bi incorporation challenging, requiring non‑equilibrium growth conditions to achieve efficient incorporation. Even when successful, Bi often segregates into clusters or droplets, creating non‑radiative recombination centers that degrade device performance. The tendency for phase separation, surface droplets, atomic ordering, and nanodroplets has been documented by X‑ray absorption spectroscopy (XAS), atomic force microscopy, and XRD [11–13]. Electron spin resonance (ESR) studies show that roughly 10 % of incorporated Bi occupies Ga sites [14]. Consequently, a deep understanding of Bi incorporation and defect formation is essential for device optimization. Advanced characterization tools, notably aberration‑corrected HAADF‑STEM, enable sub‑angstrom imaging of dilute alloys, where intensity scales with the average atomic number (Z) [15–18]. qHAADF analysis further correlates HAADF intensity with atomic column composition in III–V alloys [12, 16, 18], while high‑resolution images reveal crystalline quality [19–22].
This work employs aberration‑corrected HAADF‑STEM and complementary EDX to probe Bi distribution in GaAs/GaAs1-xBix/GaAs heterostructures grown by MBE at ~340 °C. We also examine the impact of Bi segregation on the nano‑ and micro‑scale structure, using qHAADF, FFT analysis, and XRD.
Methods
Two heterostructures were fabricated by solid‑source MBE on 2″ n+ GaAs:Si (001) wafers. Sample S1 was grown with a Bi cell temperature of 460 °C, while S2 used 505 °C. The VG V80 MBE system operated at a background pressure of ~5 × 10−10 mbar. Each structure comprised a 130 nm GaAs buffer, a 130 nm GaAs1-xBix layer, a 5 nm GaAs spacer, and a 130 nm GaAs cap. Growth temperatures were ~580 °C for GaAs layers and ~340 °C for the GaAsBi layer under near‑stoichiometric As4 flux. The GaAsBi layer was annealed in situ at ~580 °C for ~20 min during cap growth. No surface metallic droplets were observed. Substrate temperatures were calibrated by optical thermometry and surface reconstruction markers.
Cross‑sectional specimens were prepared by mechanical grinding and Ar+ ion milling using a precision ion polishing system (PIPS). Final milling employed 1.5 kV to improve surface quality, and samples were plasma‑cleaned to minimize electron‑beam deposition.
HAADF‑STEM, zero‑loss EELS, and EDX line scans were performed at 200 kV on a Titan3 Themis microscope equipped with a Cs corrector, monochromator, and Super‑X EDX detector. Secondary electron images were acquired on a FEI NOVA NANOSEM 450 at 2 kV. Bi quantification used the Bi‑M line at 2.42 keV with Bruker Espirit software. Specimen thickness was derived from spatially resolved zero‑loss EELS using Digital Micrograph (GATAN™). qHAADF analysis was conducted with the Digital Micrograph plugin, mapping integrated intensity around atomic columns. ω‑2θ (0 0 4) XRD spectra were recorded on a Bruker D8 Discover diffractometer (Cu‑Kα1) and simulated with Bede Rads Mercury.
Results and Discussion
Figure 1 displays low‑magnification HAADF‑STEM images of the [110] zone axis for samples S1 (a) and S2 (b), along with thickness‑gradient‑corrected intensity profiles (green rectangles). No threading dislocations or stacking faults were detected. In HAADF, intensity is proportional to the average atomic number; thus, brighter regions indicate higher Bi content (ZBi = 83, ZGa = 31, ZAs = 33). Sample S1, with lower Bi, shows no pronounced contrast variations, whereas sample S2 exhibits regularly distributed brighter spots along the GaAsBi layer and interfaces, interpreted as Bi‑rich clusters. These clusters are embedded within the layer, as confirmed by low‑voltage SEM topography matching the STEM images.

Intensity profiles (Fig. 1c) reveal similar layer thicknesses (~140 nm) for both samples. The GaAsBi/GaAs interface shows a gradual intensity drop over ~10 nm, implying Bi incorporation into the GaAs cap even without a Bi flux. In the low‑Bi sample (S1), the interface is sharper than in S2, suggesting a higher Bi incorporation coefficient at lower Bi flux, consistent with kinetic‑limited growth [26].
STEM‑EDX maps (Fig. 2) confirm the HAADF observations. The average Bi atomic fraction was 1.2 ± 0.4 % in S1 and 5.3 ± 0.4 % in S2, confirming non‑uniform Bi distribution. Bi clusters arise from steric hindrance; larger Bi atoms impede Ga incorporation, creating vacancies and leading to Bi segregation. EDX elemental maps of a cluster (Fig. 2b) show simultaneous decreases in Ga and As signals where Bi is high, indicating Bi occupies both group III and group V sites.

High‑magnification HAADF‑STEM images in the [110] projection were analyzed using qHAADF. Integrated intensities of group V columns were compared to those of bulk GaAs to obtain the ratio R = IAs‑Bi/IAs. Figure 3a shows the interface for S1; the R map (Fig. 3b) displays values ranging from 1.00 to 1.27, indicating a 27 % Bi enrichment in the highest‑intensity columns. The coefficient of variation (Cv) was 1.3 % in the GaAs substrate, 2.6 % in the GaAsBi layer, and 2.6 % in the cap, reflecting Bi‑related compositional fluctuations.

For sample S2, HAADF‑STEM reveals ≈ 12 nm equiaxial clusters uniformly distributed in the GaAsBi layer and at interfaces (Fig. 4a). Low‑pass filtering (Fig. 4b) highlights {111} and (001) facets. The clusters consist of a Bi‑rich core (≈ 30 % Bi) surrounded by a lower‑Bi shell, similar to observations in GaAs1-xBix/GaAs1-yBiy multilayers [10]. qHAADF mapping (Fig. 4c) shows a pronounced Bi gradient peaking at the cluster centre. FFT analysis of selected regions (Fig. 4d) reveals additional {102} spots attributable to rhombohedral Bi (rh‑Bi) nucleating within the zinc‑blende matrix, indicating phase coexistence and local strain relaxation.
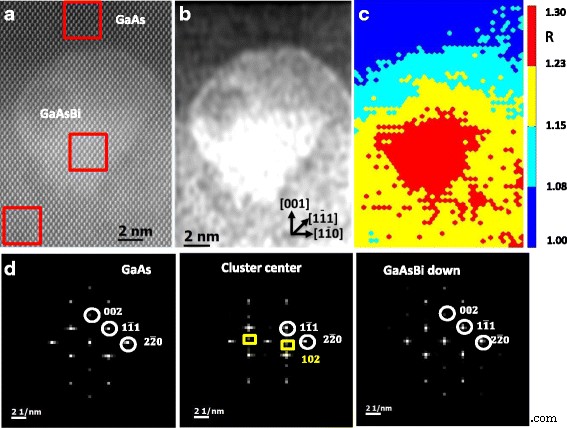
XRD ω‑2θ scans (Fig. 5) show sharp GaAs substrate peaks and broader GaAsBi peaks at negative angles, indicating strain. In S2, a shoulder on the GaAs peak signifies tensile strain in the cap, confirming partial relaxation of the GaAsBi layer. Simulations based on EDX and HAADF data (5.8 % Bi) fit the XRD curve reasonably for S1, but for S2 the presence of Bi‑rich clusters necessitates a higher average Bi content (~6 %) to match the observed peak positions, corroborating the HAADF‑STEM findings.

Conclusions
Aberration‑corrected HAADF‑STEM, complemented by qHAADF, FFT, and XRD, provides a comprehensive view of Bi distribution in GaAs/GaAs1-xBix/GaAs heterostructures. Low‑Bi samples exhibit sharp interfaces with minor Bi segregation, whereas high‑Bi samples form ≈ 10–12 nm equiaxial Bi‑rich clusters throughout the matrix. These clusters contain both rhombohedral Bi and zinc‑blende phases, inducing local lattice relaxation and partial strain relief. The observed Bi segregation and phase coexistence are key parameters for tailoring the optical and electronic properties of GaAsBi‑based devices.
Abbreviations
- Ac-HAADF-STEM
Aberration‑corrected high‑angle annular dark‑field scanning transmission electron microscopy
- EDX
Energy‑dispersive X‑ray
- EELS
Electron energy loss spectrum
- ESR
Conventional electron spin resonance
- FEG
Cold field emission gun
- FFT
Fast Fourier transform
- HRTEM
High‑resolution transmission electron microscopy
- IMEYMAT
Instituto Universitario de Investigación en Microscopía Electrónica y Materiales
- MBE
Molecular beam epitaxy
- qHAADF
Quantitative HAADF image analysis algorithm
- SEM
Scanning electron microscope
- XAS
X‑ray absorption spectroscopy
- XRD
X‑ray diffraction
Nanomaterials
- Advanced Waveform Analysis with Winscope: From Time‑Domain to Frequency Domain
- AC Analysis Configuration: Curves, Points, and Frequency Sweep Settings
- Component Failure Analysis: Troubleshooting Techniques for Series and Parallel Circuits
- Advanced Component Failure Analysis: Qualitative Techniques for Troubleshooting Complex Circuits
- Network Analysis Explained: Advanced Techniques for Complex Electrical Circuits
- Infrared Reflectance Analysis of Si-Doped Epitaxial GaN Layers Grown on Sapphire Substrates
- Engineering Bismuth Quantum Dots in Annealed GaAsBi/AlAs Quantum Wells for Advanced Optoelectronics
- Comprehensive Failure Analysis: Preventing Equipment Loss and Reducing Costs
- Agilent GPC/SEC: Precise Molecular Weight Profiling of Biodegradable Polymers
- Distribution Planning (DRP): A Strategic Guide to Efficient Supply Chain Scheduling



