Uniform Indium Quantum Dots Formed via Two‑Step Cooling on InGaN Surfaces: A Novel MOCVD Approach
Abstract
A new metal‑organic chemical vapor deposition (MOCVD) technique has been developed to grow indium quantum dots (In QDs) directly on the surface of an InGaN epitaxial layer. By applying a two‑step cooling protocol, the In QDs emerge with highly uniform size. Detailed analysis reveals that the dots form from the reaction between the surface‑rich indium layer and hydrogen gas during the low‑temperature stage of the cooling cycle. The dot density closely follows the characteristics of the surface indium layer, offering a direct probe of this otherwise elusive surface region.
Introduction
Indium gallium nitride (InGaN) has become the cornerstone of high‑efficiency light‑emitting diodes (LEDs) and laser diodes (LDs) due to its high absorption, wide spectral tunability, and radiation hardness [1‑5]. However, fabricating high‑quality InGaN remains challenging. Lattice mismatch between InN and GaN produces a solid‑phase miscibility gap [6,7], while the higher vapor pressure of InN compared to GaN suppresses indium incorporation [8]. Moreover, differing formation enthalpies drive pronounced indium surface segregation during growth [9]. During InGaN layer deposition, an indium‑rich surface layer inevitably forms because of the pulling effect, which can contaminate subsequent multiple quantum well (MQW) structures [10]. Overcoming these obstacles is essential for pushing the performance of InGaN‑based optoelectronics. While optimizing growth parameters for a single InGaN layer, we observed that a two‑step cooling regimen, rather than the conventional one‑step cooldown, consistently produced uniform‑size In QDs on the surface. This observation prompted a systematic investigation into the underlying mechanism and its implications for surface‑layer characterization.
Experiment
Samples were grown on c‑plane sapphire using an AIXTRON 6 × 2 in close‑coupled showerhead MOCVD reactor under a nitrogen atmosphere. Trimethylgallium (TMGa), trimethylindium (TMIn), and ammonia (NH₃) served as Ga, In, and N precursors, respectively. Single InGaN layers (<60 nm thick, <15 % In) were deposited atop a 2‑µm unintentionally doped GaN buffer, which itself rested on a 25‑nm GaN seed layer (Fig. 1). Hydrogen (H₂) was employed as the carrier gas during GaN growth to improve crystal quality, whereas nitrogen (N₂) was used for the InGaN layer to prevent indium corrosion [11,12]. Conventional cooling involves a direct temperature drop to room temperature in N₂ (“one‑step cooling”). Our novel “two‑step cooling” protocol first reduces the temperature to 400 °C in N₂, followed by a final drop to room temperature in H₂. Structural and morphological characterization employed high‑resolution X‑ray diffraction (XRD), atomic force microscopy (AFM), scanning electron microscopy (SEM), and energy‑dispersive spectrometry (EDS). The schematic of the sample structure is shown in Fig. 1.
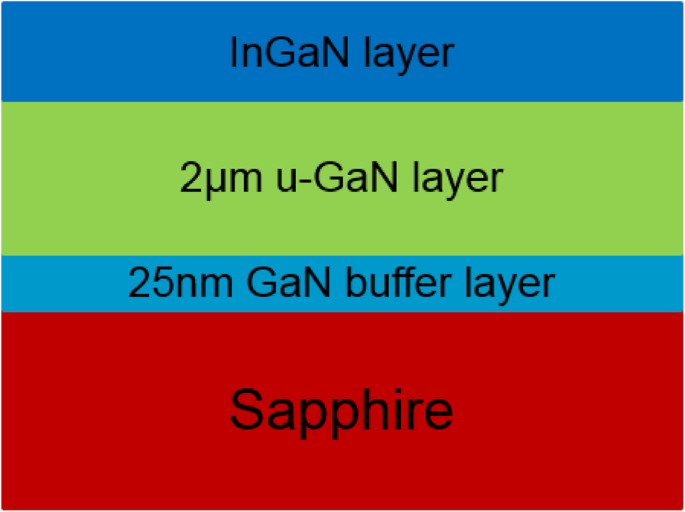
The structure schematic of a single InGaN layer grown on a GaN template on sapphire.
Result and Discussion
AFM images reveal a distinct surface morphology for samples cooled with the two‑step protocol compared to the one‑step method (Fig. 2a,b). While both display the characteristic step‑flow 2D growth of InGaN and 3D islands associated with screw dislocations, the two‑step cooled surface also exhibits numerous uniform‑size quantum dots (average 100 × 100 nm, ~20 nm tall, density ~1.6 × 10⁸ cm⁻²). The key variable is the use of H₂ during the low‑temperature stage; thus the dot formation is linked to hydrogen’s interaction with the surface indium layer.
To isolate the effect of the cooling gas, we applied the same two‑step cooling to GaN layers grown under identical conditions. AFM shows no dots on GaN (Fig. 3a), confirming that the phenomenon is specific to InGaN. When the In content is reduced to 1 %, the dot density drops sharply (Fig. 3b), indicating a direct correlation with surface indium concentration.
XRD scans further distinguish the dots’ composition. Two‑step cooled samples display an additional peak at 2θ = 32.8°, absent in one‑step samples. This peak aligns with known diffraction from indium droplets [16,17], confirming that the dots are indium‑rich. SEM and EDS mapping (Fig. 5) corroborate that the dots are enriched in indium while surrounding Ga and N remain uniformly distributed.
An intriguing observation is that annealing the InGaN surface at 800 °C for 60 s removes the indium‑rich layer. Subsequent two‑step cooling fails to produce dots (Fig. 6), establishing that the dots originate from the indium‑rich surface layer rather than the bulk InGaN lattice.
We propose that hydrogen acts as a corrosive agent at low temperatures (<400 °C), converting surface indium nitride to metallic indium and ammonia (3 H₂ + 2 InN → 2 In + 2 NH₃). Unlike high‑temperature growth where liberated indium diffuses away, the low thermal energy prevents desorption, allowing indium atoms to coalesce into droplets.
Further experiments varying In content (7.65 %–9.6 %) and layer thickness (≈13 nm vs. 41 nm) demonstrate that dot density increases with both parameters (Fig. 7). This trend mirrors theoretical predictions that surface indium concentration rises with bulk InGaN composition and thickness [21], reinforcing the surface‑origin hypothesis.
AFM topography of InGaN with (a) one‑step cooling and (b) two‑step cooling; inset: 3D view of surface. AFM topography: (a) GaN with two‑step cooling; (b) InGaN (1 % In) with two‑step cooling. XRD ω/2θ spectra: two‑step cooling (red) shows an extra peak at 32.8°, confirming indium droplets. SEM image (a) and EDS maps (b–d) of In, N, Ga on two‑step cooled surface. AFM topography after 60‑s annealing at 800 °C before two‑step cooling: no dots appear. AFM topography of InGaN layers (a–d) with varying In content and thickness; higher In and thicker layers yield more dots.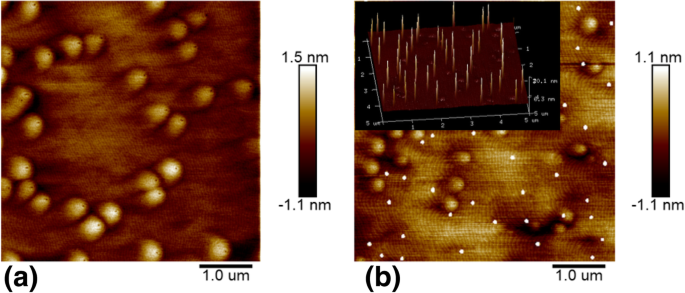
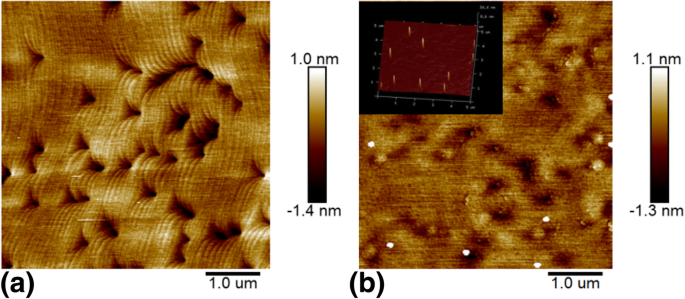
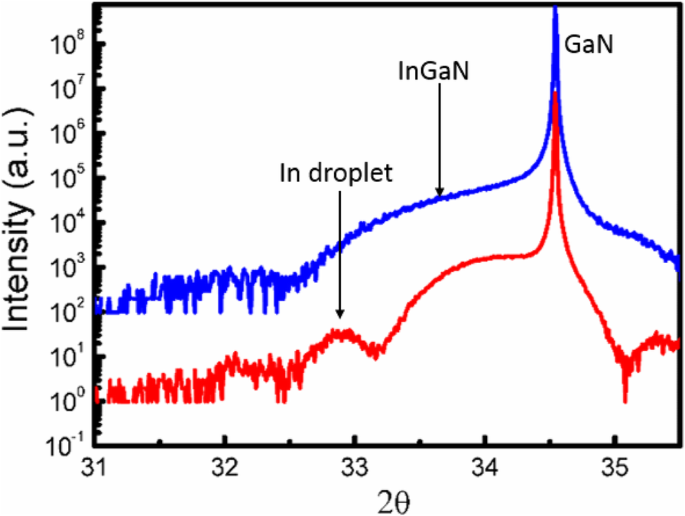
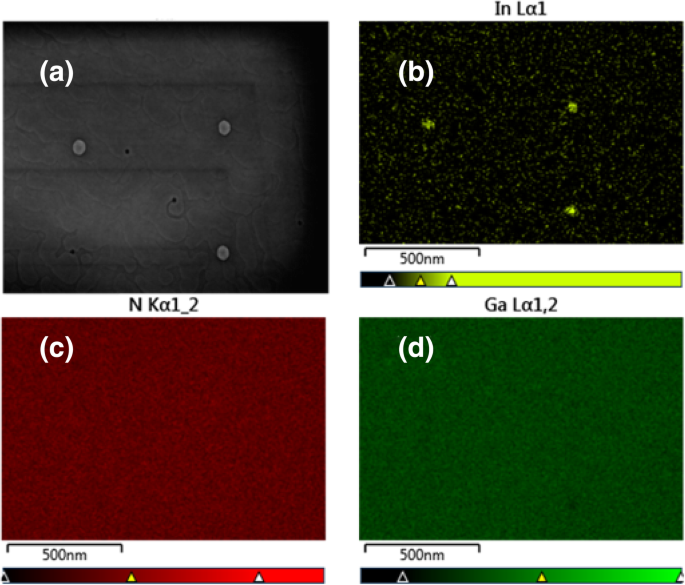
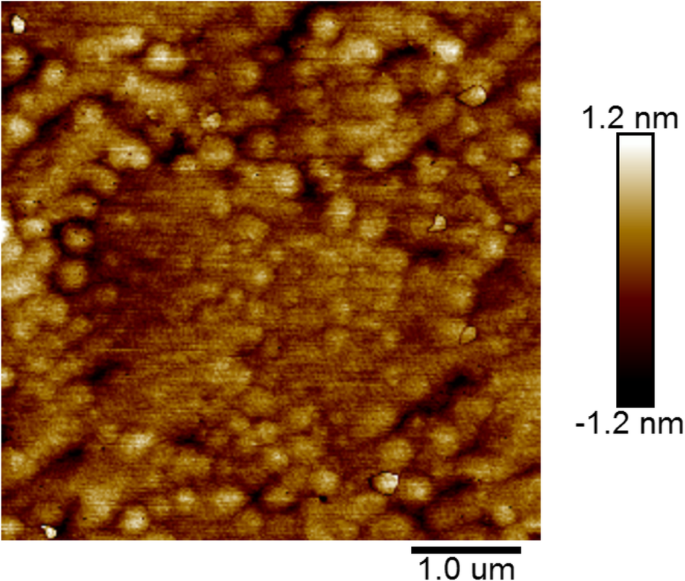
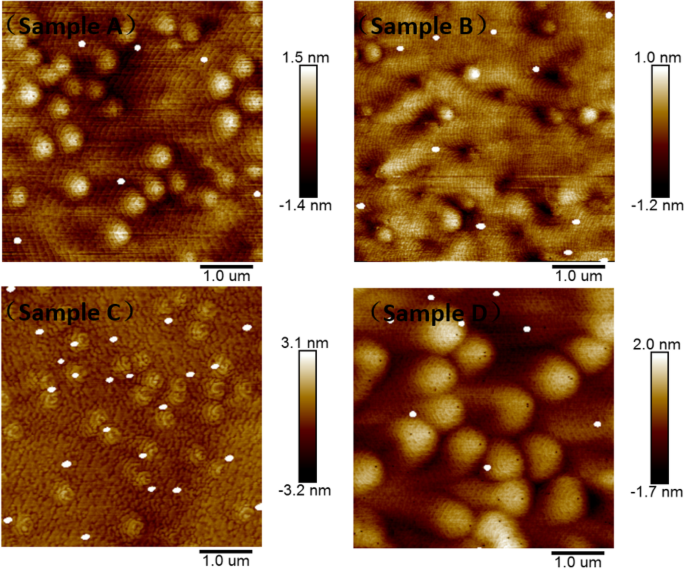
Conclusion
We have demonstrated a reproducible method to fabricate uniform‑size indium quantum dots on InGaN surfaces via a two‑step cooling scheme. The dots arise from the reaction between the indium‑rich surface layer and hydrogen gas at temperatures below 400 °C. This process not only offers a new route to nanostructure fabrication but also provides a direct, non‑destructive probe of the elusive indium‑rich surface layer that impacts subsequent device performance.
Method
Samples were fabricated using an AIXTRON 6 × 2 in close‑coupled showerhead MOCVD reactor. Characterization employed XRD, AFM, SEM, and EDS. The study was conducted by researchers from the University of Chinese Academy of Sciences.
Availability of Data and Materials
The datasets used and/or analyzed during this study are available from the corresponding author upon reasonable request.
Abbreviations
- AFM
Atomic force microscopy
- EDS
Energy dispersive spectrometer
- GaN
Gallium nitride
- In QDs
Indium quantum dots
- InGaN
Indium gallium nitride
- InN
Indium nitride
- LD
Laser diode
- LED
Light‑emitting device
- MOCVD
Metalorganic chemical deposition
- MQW
Multiple quantum well
- NH3
Ammonia
- QDs
Quantum dots
- SEM
Scanning electron microscope
- TMGa
Trimethylgallium
- TMIn
Trimethylindium
- XRD
X‑ray diffraction
Nanomaterials
- N,N‑Dimethylformamide Modulates MXene Quantum Dot Fluorescence for Ultra‑Sensitive Fe³⁺ Detection
- Optimizing ZnO Film Morphology and Properties via Interfacial Layer Design
- Enhanced Telecom-Range Photoconductivity in Metamorphic InAs/InGaAs Quantum Dots (1.3–1.55 µm)
- Temperature and Excitation Intensity Modulate Photoluminescence in InGaAs/GaAs Surface Quantum Dots
- Tailoring Optical Properties of InAs Quantum Dots with InAlAs Interlayers in GaAsSb Strain‑Reducing Layers
- GaN Cap Layer Thickness Alters Carrier Localization and Thermal Stability in InGaN/GaN Quantum Wells – Photoluminescence Insights
- How Edge Functionalization Alters Fluorescence in Carbon Quantum Dots
- Speed-Locking of Particles on Graphene under Traveling Surface Waves
- Optical Performance of InGaN/GaN Quantum Wells: Effect of GaN Cap Layer Thickness
- Enhancing InGaN/GaN μLED Efficiency by Thinning Quantum Barriers to Reduce Surface Recombination



